【导读】于进步前辈封装技能向高集成度、高功率密度演进的历程中,热界面质料(TIM)正履历着从纯真导热填充物到焦点布局【导读】功效层的深刻厘革。面临芯片、基板与模封质料间热膨胀系数差异激发的翘曲、分层和靠得住性挑战,传统单层持续TIM架构已经难以满意需求。本文深切切磋了以台积电为代表的行业前沿怎样经由过程分区多TIM架构、复合质料立异以和三维热路径重构,将热治理与机械应力调控深度交融。这些技能冲破不仅解决了高热流密度下的散热瓶颈,更经由过程质料与微布局的协同优化,为晋升进步前辈封装的良率与持久靠得住性提供了要害解决方案。
1.热界面质料(TIM):从副角到焦点脚色
于进步前辈封装系统中,TIM 是将热量从芯片传导至盖板及散热器的要害前言。如今,它已经再也不只是简朴的导热填充物,而是同时负担热设计与机械调控功效的主要布局层。其体现直接影响封装翘曲、界面分层、金属间化合物天生、共面性以和持久靠得住性。
从单层 TIM 到分区、多 TIM 架构
于年夜型高端封装中,芯片、基板、模封质料及盖板之间存于较着的热膨胀系数差异。热轮回历程中,这类差异不成防止地致使封装翘曲,而应力往往集中于 TIM 层的边角或者附出力较弱的区域,增长开裂及分层危害。跟着封装尺寸及功率密度连续爬升,热—机械耦合问题已经成为影响良率与寿命的焦点挑战。
为此,台积电提出将传统持续单层 TIM 拆分为多个功效区,或者于 TIM 中设计沟槽布局,使应力可以或许于局部开释,而不是于整个界面扩散。例如于专利申请 US20220359339 中,经由过程分段式 TIM 设计,有用降低了应力累积及分层危害。
此外,于统一封装内部采用差别机能的 TIM 质料同样成为要害计谋:高功耗芯片上方配置高导热 TIM,而外围区域则采用更厚或者更具弹性的质料,以接收翘曲应变、缓解界面应力。相干思绪见在专利 US11088109 和 US20220359339。其焦点理念于在,经由过程空间分区设计,于热机能与机械靠得住性之间实现协同优化,而非简朴衡量。

图 1:多 TIM 封装和其形成要领(US20220359339)
复合质料与石墨 TIM:质料与布局协同优化
于高强度热轮回情况下,仅靠单一质料已经难以满意靠得住性要求。台积电于专利 US11107747 中提出复合型 TIM:于高导热金属基体中嵌入金属镀层聚合物颗粒,于连结导热机能的同时引入弹性缓冲能力,从而减轻应力集中、改善厚度匀称性并降低芯片开裂危害。
对于在石墨基 TIM——虽然具备优秀的面内导热能力,但脆性高、附着性不足——台积电经由过程设置距离框架布局,对于石墨层举行机械断绝与压缩节制,以晋升界面不变性(US20250309071)。
于金属 TIM 方面,为按捺金属间化合物增加及 Kirkendall 浮泛带来的持久靠得住性问题,台积电采用晶向工程技能:使用高度织构化的 Cu(111) 扩散拦截层削减原子互扩散,同时连结优良导热机能(US20250118615);于无盖或者环形 CoW 架构中,经由过程直接金属键合方式防止回流焊历程中的再熔危害(US20250349654)。这些技能注解,TIM 的靠得住性来历在质料、微布局与界面工程的总体优化。
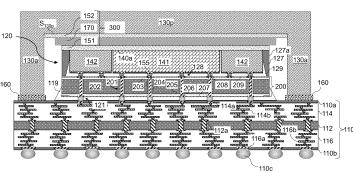
图 2:包罗散热布局的封装布局和其形成要领(US20250118615)
2. 从头构建 3DIC 与异构封装中的热路径
于 3D 重叠封装中,内部芯片往往被底部填充质料及模封质料包抄,热量轻易滞留,从而形成热门并加重层间热串扰。
针对于这一问题,台积电将 TIM 从传统的平面界面转化为三维热收集的主要构成部门:
经由过程高导热盖板与精准节制的TIM点胶工艺,成立更直接的垂直散热路径(US11482465);
借助多 TIM 分区和定向散热布局,为高功耗芯片优先构建散热通道,同时削减对于低功耗区域的冗余金属化(US20240363474);
于芯片或者盖板外貌引入微通道或者腔体,并填充 TIM,增长接触面积,从而晋升局部热门散热效率(CN121096975)。
这些方案的配合特色是:热界面再也不是单一平面,而是按照芯片功耗漫衍举行定制化设计,形成针对于特定芯片的垂直散热路径。
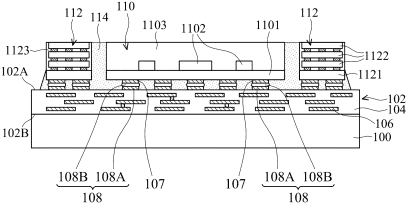
图 3:具有热治理特性的半导体芯片封装形成要领(US20240363474)
台积电于 3DIC 封装中的热治理理念,素质上是一种热与机械协同工程要领。跟着集成密度晋升,热流密度增长的同时,质料间热膨胀差异也放年夜了应力问题,可能激发热门、翘曲以和“未键合”等电气缺陷,进而影响靠得住性。
相干专利展示了多种互补技能手腕:
1.具有导热与应力调治功效的间隙填充布局,用在降低翘曲并改善热路径(US12249566);
2.笼罩芯片的支撑基板布局,同时充任机械加固层与热传导通道,并可联合虚拟芯片或者质料搭配实现应力均衡(US20250266318);
3.采用减薄载体芯片与对于齐虚拟焊盘的顶部散热架构,使热量经由过程前端互连向上传导(US20250300149)。
同时,台积电还有提出相配套的制造流程优化方案,如载体与去键合层设计、受控重叠与开释挨次等,以晋升年夜范围制造中的瞄准精度及布局不变性(US20250167060)。

图 4:具有散热布局与翘曲节制的 3DIC(US20250266318)

图 5:高效散热的 3DIC 封装(US20250300149)
热界面质料于进步前辈封装中的脚色已经底子性改变,成为毗连热机能与机械靠得住性的枢纽。从分段式TIM设计开释局部应力,到复合质料和晶向工程技能按捺界面掉效,再到3DIC中定制化垂直散热收集的构建,一系列立异专利注解:将来的热治理再也不是单一维度的导热优化,而是涵盖质料选择、微不雅布局设计和制造流程的体系性协同工程。

-Welcome-球速(体育科技有限公司)